TSMC, 애플의 Ultra Fusion 칩 상호간 연결이 확인 했습니다
| 출처 | https://www.tomshardware.com/news/tsmc-clarifies-apple-ultrafusion-chip-to-chip-interconnect |
|---|

TSMC는 최근 Apple이 InFO_LI 패키징 방법을 사용하여 M1 Ultra 프로세서를 구축하고 UltraFusion 칩 간 상호 연결을 가능하게 했음을 확인했습니다. Apple은 InFO_LI 기술을 사용하는 최초의 회사 중 하나입니다.
Apple이 올해 초 20코어 M1 Ultra 프로세서를 출시했을 때 UltraFusion 2.5TB/s 프로세서 간 상호 연결로 관찰자들에게 깊은 인상을 주었고 어떤 종류의 패키징 기술을 사용했는지 궁금하게 만들었습니다. Apple이 TSMC의 칩 생산 서비스를 이용하고 있기 때문에 TSMC의 패키징 기술 중 하나를 사용했다고 가정하는 것이 합리적입니다.

지난 3월, Apple이 TSMC의 CoWoS-S(chip-on-wafer-on-substrate with silicon interposer) 2.5D 인터포저 기반 패키징을 선택했다는 소문이 돌았습니다. . 분명히 이것은 정확하지 않습니다. 3D IC 및 이기종 통합에 관한 국제 심포지엄에서 파운드리가 시연한 프레젠테이션에 따르면 Apple은 로컬 실리콘 상호 연결(LSI) 및 재배포 레이어(RDL)와 함께 InFO(통합 팬아웃)를 사용합니다. 슬라이드는 반도체 패키징 엔지니어링 전문가인 Tom Wassick 이 다시 게시했습니다
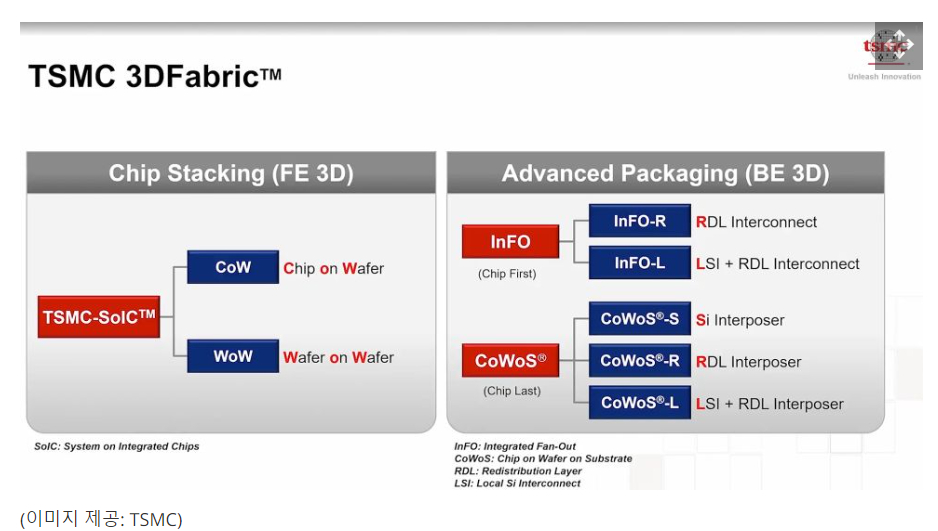
궁극적으로 Apple의 UltraFusion 칩 대 칩 상호 연결은 M1 Max를 다른 M1 Max 프로세서에 연결하여 M1 Ultra를 구축하는 수동 실리콘 브리지를 사용하지만 이러한 브리지를 구현하는 방법에는 여러 가지가 있습니다. InFO_LI는 크고 값비싼 인터포저 대신 여러 다이 아래에 국부적인 실리콘 인터커넥트를 사용합니다. 이는 인텔의 임베디드 다이 인터커넥트 브리지(EMIB) 와 매우 유사한 개념입니다 .
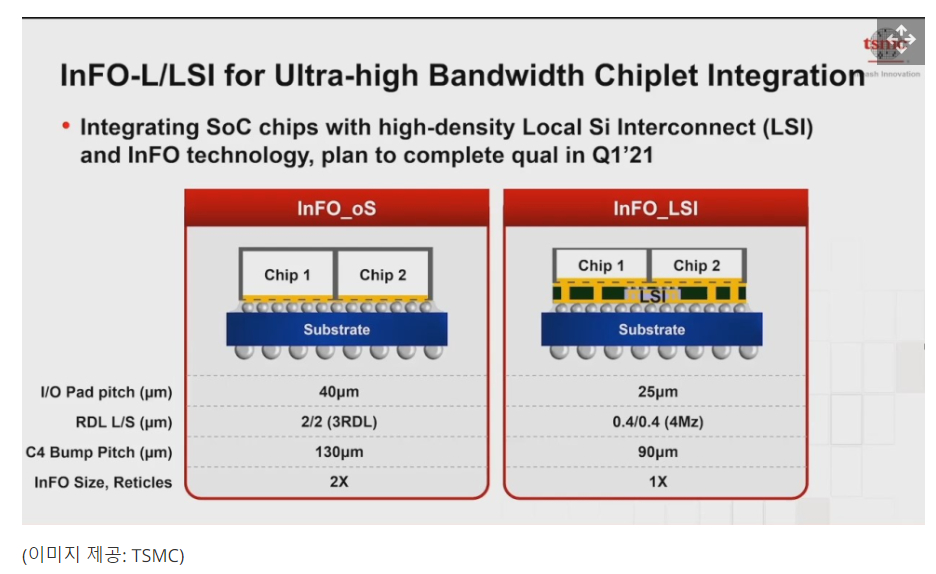
이와 대조적으로 CoWoS-S는 고가의 인터포저를 사용하므로 매우 '광범위한' 인터커넥트(멀티 칩렛 + HBM 메모리 통합에 필요)가 필요하지 않는 한 InFO가 비용 측면에서 선호되는 기술입니다. 한편, 애플은 HBM 메모리 를 사용하지 않고 인터포저보다 큰 다이를 2개 이상 통합할 필요가 없기 때문에 M1 울트라는 InFO만으로도 충분하다.
Apple이 InFO_LI 대신 CoWoS-S를 사용할 수 있다고 생각한 이유 중 하나는 전자는 상업적으로 사용할 준비가 되었지만 후자는 2021년 1분기에 인증을 완료할 예정이기 때문입니다. Apple은 2분기 또는 2021년 3분기에 회사가 중요한 디자인 중 하나에 완전히 새로운 포장 기술을 사용할지 확신할 수 없었습니다.




























